세계 최고 기술력의
High-end 동박
동박은 인공지능(AI) 가속기와 자율주행 레이더 등 첨단 전자장비에서 전자가 이동하는 핵심 소재입니다.
솔루스첨단소재는 유럽 유일의 동박 제조 업체로서 65년의 오랜 제조 경험과 노하우를 바탕으로 글로벌 시장에서 지속적으로 시장을 선도하고 있습니다.
사업 소개
세계 최고 기술력의 High-end 동박으로 AI 시대를 만들어갑니다.
동박은 조도(거칠기)가 균일하면서도 절연필름과의 밀착력을 우수하게 만드는 것이 핵심 기술입니다.
1.5㎛ 초극박 제조 기술력을 확보하여 PCB 기판의 미세화로화, 고집적화, 고다층화에 기여하고 있습니다.
최근에는 AI 가속기에도 솔루스첨단소재의 동박이 사용되며 글로벌 빅테크 기업으로부터 기술력을 인정받고 있습니다.

강점
- AI 가속기용 HVLP 동박
-
- 균일한 표면처리 기술로 0.4㎛(Rz JIS 기준)의 조도(거칠기)를 형성해 신호손실을 최소화하는 Low signal loss용 동박을 제조해 인공지능(AI) 가속기 등에 적용하고 있습니다.
- 세계 선도 극박(Thin foil) 제조 기술 보유
-
- 1~2㎛의 극박을 양산하고 있으며, High-end PCB(전자회로기판)의 미세회로화, 고밀도, 고집적화 및 고다층화에 적합한 제조 공법을 보유하고 있습니다.
- IC/USIM card용 동박 전세계 독점
-
- 고강도, 고연신율 동박 제조 기술과 습기 등 외부환경으로부터의 손상을 방지하는 특수 표면처리 기술을 통해 IC Card 및 USIM Card에 적합한 동박을 전세계 독점 공급하고 있습니다.
제품 용도
- AI 가속기

- 반도체용 PKG

- Flexible PCB
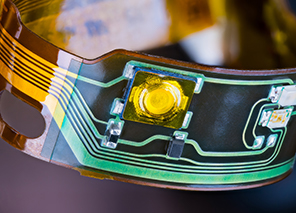
- 항공기

- 위성통신

- IC, USIM 카드

- 통신 기지국 레이더

- 자율주행 자동차 레이더

주요 제품
-
- 초극저조도 동박 HVLP (BFL-NN-Z, BFL-NX-Y)
-
- 낮은 표면조도(표면 거칠기)특성 보유
- 조도 0.4um 이하(JIS 기준)에서 안정적인
Peel strength 특성 보유(0.5N/mm 이상)
- 조도 0.4um 이하(JIS 기준)에서 안정적인
- AI반도체 및 고효율 신호전송용 네트워크 기판소재에 활용
- 5G 통신장비 및 전장용 자율주행 레이더 부품등에 활용
- HVLP4, HVLP5 개발 완료
- 두께: 9~35um
-
- 극박 (DTH-N-TZA, DTH-ANP)
-
- 얇은 두께의 제품으로 IC Package* 및 HDI application* 적용 가능
- MSAP* 에 적용 가능하며, 회로폭(Line & Space) 30/30um 이하 구현 가능
- 대량 양산을 위한 전용 설비 운영 중
- 두께: 1.5~5um
* IC: Integrated circuit
* HDI: High density interconnection
* MSAP: Modified Semi-Additive Process
-
- Smart IC용 (LPT-TZA, LPT-NP)
-
- Smart IC용 동박
- 고강도 저조도 동박
- Reel-To-Reel 공정에 최적화
- 고성능 IC chip 탑재를 위한 우수한 평탄도 특성 보유
- 두께: 18~70um
생산 공정
제품 분류
| 제품분류 | 소분류 | 제품 명 | 제품 용도 | 특징 |
|---|---|---|---|---|
| HVLP (Hyper Very Low Profile, 초극저조도 동박) | HVLP5 | BFL-NF | 고성능 AI가속기 기판소재용 | Nodule Free 기술 적용. 현존 최고의 신호전송 특성 보유 |
| HVLP4 | BFL-NX | 고성능 AI가속기 기판소재용 | 초미세 Nodule Treatment 기술력 적용. 신호전송 특성 Upgrade | |
| HVLP3 | BFL-NN | 고성능 AI가속기 기판소재용 | 극저조도 ( 0.6um 이하) 특성 및 우수한 접착강도. 우수한 신호전송 특성으로 고성능 AI가속기 기판에 적합 |
|
| HVLP2 | BF-ANP | 초고속 송신 디지털 장비 기판소재용 | 1.0um 이하수준의 매우 낮은 조도에서 우수한 접착력 구현 가능 | |
| HVLP | BF-TZA | 고속 송신 디지털 장비 기판소재용 | Low loss 특성의 기판에 우수한 접착력 구현 및 매우 낮은 조도 보유 | |
| BF-HFI-LP2 | 고속 송신 디지털 장비 기판소재용 | Low loss 특성의 기판에 우수한 접착력 구현 및 매우 낮은 조도 보유 | ||
| RTF (Reverse Treated Foil, 역처리동박) | RTF3 | TZA-B3 | 고속 송신 디지털 장비 기판소재용 (Reverse 표면처리 동박) |
Reverse 표면처리제품. RTF2 제품대비 낮은 조도 특성 보유. 현존 RTF 제품중 가장 우수한 신호전송 특성 보유 |
| RTF2 | TZA-B2 | 고속 송신 디지털 장비 기판소재용 (Reverse 표면처리 동박) |
Reverse 표면처리제품. 기본 RTF제품대비 낮은 조도 특성 보유하여 신호전송 특성 강화 | |
| RTF | TZA-B | 고속 송신 디지털 장비 기판소재용 (Reverse 표면처리 동박) |
일반박에 Reverse 표면처리하여 낮은 조도를 구현하면서도 가격경쟁력 확보가능. | |
| PKG용 극박 | - | DOUBLETHIN-CL | IC 기판 및 고다층 집적 회로용 | ETS 공법에 특화된 초미세회로용 극박 |
| DOUBLETHIN-NN | IC 기판 및 고다층 집적 회로용 | 차세대 초미세회로 설계가 적용되는 반도체기판용 극박 | ||
| DOUBLETHIN-ANP | IC 기판 및 고다층 집적 회로용 | 표면조도를 낮춰 ( 0.9um 이하) 미세회로 구현 능력 향상. | ||
| DOUBLETHIN-N-TZA | IC 기판 및 고다층 집적 회로용 | 1.5um/2um 수준의 초극박제품으로 반도체기판 미세회로 구현에 적합 | ||
| High Frequency (고주파 통신용 동박) | 불소수지용 | BF-HFA | Base station 및 전장용 RADAR/LIDAR용 | 불소소재 기판에 우수한 접착력 구현 및 낮은 조도 보유 |
| 특수수지용 | TWLS | Base station,전자용 Radar, 특수소재용 | Hydrocarbon, PPE/PPO등 특수 Resin system을 가진 수지에와 높은 접착력 구현 가능 | |
| SMART-IC (스마트IC카드용 동박) | - | LPT-NP | Smart Card / Tape Carrier 소재용 | 우수한 Elastic modulus 특성과 높은 기계적 물성 보유 |
| LPT-TZA | Smart Card / Tape Carrier 소재용 | 우수한 Elastic modulus 특성과 높은 기계적 물성 보유 | ||
| FLEXIBLE (연성회로기판용 동박) | - | BF-TZA-FX | Flexible 기판소재용 | 높은 기계적 강도와 Polyimide 필름에서 높은 접착력 구현 가능 |
| AEROSPACE (우주/항공용 동박) | - | TZA-TZA | 항공기/풍력발전기 등 낙뢰방지용 | 양면 표면처리로 접착강도 최우수 |
| REGULAR MLB (다층회로기판용 동박) | - | TZA | 일반 Multilayer 기판소재용 | 높은 고온 연신율과 내열특성 보유 |









